관련종목▶
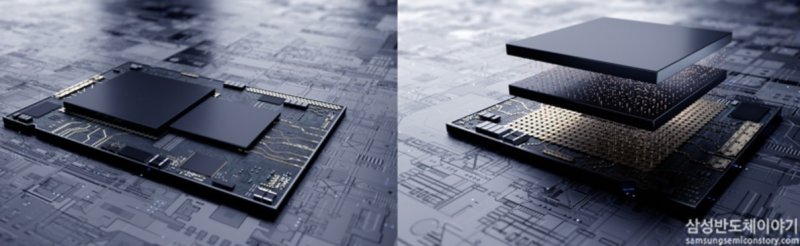
|
|||||||||||||||
[파이낸셜뉴스] 글로벌 파운드리(반도체 위탁생산) 1위인 TSMC가 공장 증설에 이어 타 기업의 공장을 인수하면서 미래 반도체 전쟁의 성패를 좌우할 패키징 생산능력 확보에 나섰다. 삼성전자도 반도체(DS)부문장 산하에 어드밴스드패키징(Advanced Packaging) 개발 조직을 직속으로 두는 등 나노전쟁에 이어 패키징 전쟁을 위해 전열 정비에 나섰다.
21일 업계에 따르면 TSMC는 최근 이사회 의결을 통해 대만 폭스콘그룹 산하 패널업체 이노룩스의 액정표시장치(LCD) 공장인 타이난 남부과학단지 4공장 인수를 결정했다. TSMC는 공시를 통해 해당 공장은 171억4000만대만달러(약 7203억9420만원)에 매입했으며, 이달 말 모든 인수절차가 마무리될 것이라고 전했다.
현지 언론과 반도체 업계는 TSMC가 이번에 인수한 공장을 자사의 첨단패키징 제품인 '칩온웨이퍼온서브스트레이트(CoWoS)' 생산에 활용할 것이라고 보고 있다. TSMC가 자체 개발한 2.5차원(2.5D) 패키징인 CoWoS는 칩과 기판 사이에 인터포저라는 얇은 막을 삽입해, 패키징 면적을 줄이고 칩 간 연결성을 높인 것이 특징이다.
AI 가속기에는 고성능 시스템반도체와 고대역폭메모리(HBM)를 함께 집적해야 하는데, 2.5D 패키징이 필수적이다. 시장조사업체 트렌드포스는 TSMC의 CoWoS 생산능력이 올해 150%, 내년 70% 이상 증가할 것으로 보고 있다. 이번 이노룩스의 공장 인수로 반도체 업계는 올해 월 4만장 전후의 CoWoS 생산능력이 2025년 6만장, 2026년 7~8만장으로 증가할 것으로 보고 있다.
웨이저자 TSMC가 회장 취임 후 첫 컨퍼런스콜에서 파운드리 사업의 개념을 재정의한 '파운드리 2.0'을 발표한 점과 이번 CoWoS 생산확대 움직임이 맞물리면서 TSMC가 파운드리에 이어 후공정영역까지 절대적인 영향을 끼치려고 한다는 분석이 나온다. 웨이 회장은 "파운드리 2.0엔 전통적인 파운드리 사업에 패키징, 테스팅(칩 성능 검사), 마스크(반도체의 원판인 웨이퍼에 회로를 새길 때 필요한 부품) 생산 등을 포함한다"며 "메모리반도체 생산을 제외한 종합반도체 사업을 하겠다"고 밝힌 바 있다.
한편, 삼성전자 DS부문은 새로운 첨단 패키징 기술인 '팬아웃(FO)-패널레벨패키지(PLP)'의 안정화에 나섰다. FO-PLP는 기존 원형 웨이퍼를 대체하기 위해 직사각형 인쇄회로기판(PCB) 패키징을 도입한 기술로, 생산 효율이 높고 비용도 절감할 수 있다. TSMC의 CoWoS가 AI 시장 수요 확대로 병목현상을 겪으며 삼성전자의 이 기술이 대안으로 주목고 있다. TSMC는 최근에서야 FO-PLP 연구·개발에 돌입했다.
파운드리와 최첨단패키징을 묶은 '턴키(일괄) 서비스'도 삼성전자만의 강점이다. 지난 6월 미국 실리콘밸리에서 개최한 파운드리포럼에선 "HBM, 파운드리, 최첨단패키징 간 협력을 통해 AI 솔루션을 선보여 고객의 공급망을 단순화하는 데 기여하겠다"며 "고객사 입장에선 생산 기간을 개별 기업에 맡길 때보다 20% 줄일 수 있다"고 말했다.
삼성전자는 지난달 전영현 DS부문장(부회장) 취임 후 첫 조직개편에서 기존 최첨단패키징 담당 조직인 AVP사업팀에서 차세대 기술 개발을 담당하던 조직은 'AVP 개발팀'으로 분리해 DS부문장 직속으로 편입됐다. 업계에서는 전 부회장이 미래 반도체의 성패를 좌우할 패키징을 직접 챙기며 경쟁력 강화에 나섰다는 분석이 나왔다.
업계 관계자는 "오랜기간 패키징에 대한 연구에 집중해 온 TSMC와 달리, 삼성전자는 후발주자로서 패키징 기술에 대한 전폭적인 연구·개발(R&D)이 필요하다"고 말했다. rejune1112@fnnews.com 김준석 기자
※ 저작권자 ⓒ 파이낸셜뉴스, 무단전재-재배포 금지

