뉴스 검색결과
"첨단패키징" 검색결과는 672건 입니다.-
 엔비디아, TSMC 첨단 패키징 용량 70% 확보… '더 벌어진' 삼성·TSMC 파운드리 격차
엔비디아, TSMC 첨단 패키징 용량 70% 확보… '더 벌어진' 삼성·TSMC 파운드리 격차
글로벌 파운드리(반도체 위탁생산) 시장에서 1위 기업인 TSMC 쏠림현상이 더 거세지고 있다. 첨단 패키징 공정기술을 발 빠르게 도입해 엔비디아 등 인공지능(AI) 그래픽처리장치(GPU)를 만드는 주요 고객사의 수요에 적극 맞춰 나가며 영향력을 키우고 있다는 분석이다. 삼성전자도 첨단 패키징 공정기술을 적극 개발하고 도입하고 있지만 아직 고객 확보에는 난항을 겪고 있다. ■엔비디아, TSMC 첨단 패키징 공정 3분의 2 "우리 것" 24일 외신 및 반도체 업계에 따르면 엔비디아는 차세대 블랙웰 아키텍처 GPU의 본격 양산에 들어가면서 TSMC의 첨단 패키징 공정인 '칩 온 웨이퍼 온 서브스트레이트'(CoWoS)-L 물량 중 70% 이상을 계약한 것으로 전해졌다. 특히 엔비디아는 미국의 오픈AI와 소프트뱅크 등이 추진 중인 '스타게이트 프로젝트'에 따라 AI 서버 및 데이터센터의 신규 구축 수요가 폭증할 것으로 보고 이에 대응하기 위해 TSMS의 CoWoS-L 캐파(생산능력)를 대거 선점한 것으로 분석된다. TSMC의 CoWoS-L은 재배선층(RDL)을 기반으로 로컬 실리콘 인터포저(반도체 칩과 기판 사이를 중재하는 부품)를 연결단자로 사용하는 방식을 채택하는 등 더 정교한 패키징을 요구하는 공정이다. 성능, 수율 및 비용 측면에서 이전 CoWoS-S 및 CoWoS-R 고급 패키징 기술보다 우수하고 기술적 난이도가 높아 차세대 패키징 방식으로 불린다. TSMC는 CoWoS-L 공정 생산용량 확대를 위해 대만과 일본 등지에서 적극적으로 패키징 공장을 확장하고 있다. 업계 관계자는 "AI 반도체의 핵심은 단순한 칩 제조가 아니라 고급 패키징 기술 등을 결합해 최적의 성능을 내는 것"이라며 "향후 AI 반도체 시장에서 패키징 기술경쟁은 더욱 치열해질 것"이라고 내다봤다. ■삼성 패키징 승부수에도…격차는 점차 벌어져 TSMC가 CoWoS-L을 앞세워 AI 칩 패키징 시장에서 강력한 우위를 점하고 있는 가운데 삼성전자도 자체 패키징 기술을 내부적으로 키우고 있다. 삼성전자는 2.5차원 패키지 솔루션 '아이큐브(I-Cube)'와 3차원 솔루션 '엑스큐브(X-Cube)' 기술 등을 고도화해 AI 반도체 시장에서 경쟁력을 확보하기 위해 총력을 다하고 있다. 송재혁 삼성전자 반도체(DS) 부문 최고기술책임자(CTO) 겸 반도체연구소장 사장도 지난 19일 열린 국내 최대 반도체 전시회 '세미콘 코리아 2025' 기조연설에서 "반도체의 성능을 높이고 전력소모를 낮추기 위해 실리콘 프로세스(전공정)도 중요하지만, 기술한계로 미세 프로세스 개발이 늦어지고 있다"며 "패키징(후공정) 기술 등으로 기술적 한계를 극복할 수 있다"고 강조했다. 다만 TSMC와는 매 분기 점유율 격차가 벌어지며, 삼성전자는 고객사를 확보하는 것 자체에 난항을 겪고 있다. 실제 시장조사업체 트렌드포스에 따르면 지난해 3·4분기 파운드리 시장점유율은 TSMC 64.9%, 삼성전자 9.3% 등으로 TSMC가 전체 시장의 절반 이상을 차지하고 있다. 업계 관계자는 "삼성전자가 파운드리에서 수익을 내기 위해 주요 고객사를 확보하는 것이 시급하지만, 패키징에서 TSMC의 CoWoS-L에 비해 상대적으로 뒤처져 있고 TSMC 대비 3나노미터(1㎚=10억분의 1m) 최신 공정에서 수율 안정성이 낮은 상황"이라고 진단했다. soup@fnnews.com 임수빈 기자
2025-02-24 18:25:50 -
 TSMC '엔비디아' 맞춤 첨단 패키징 캐파도 늘려…삼성과 격차는 더 확장
TSMC '엔비디아' 맞춤 첨단 패키징 캐파도 늘려…삼성과 격차는 더 확장
[파이낸셜뉴스] 글로벌 파운드리(반도체 위탁생산) 시장에서 1위 기업인 'TSMC 쏠림 현상'이 견고해지고 있다. 첨단 패키징 공정 기술을 발 빠르게 도입해 엔비디아 등 인공지능(AI) 그래픽처리장치(GPU)를 만드는 주요 고객사의 수요에 적극 대처하면서다. 한편 TSMC 대항마로 꼽혔던 삼성전자가 고전을 면치 못하는 데다가 중국 파운드리 기업이 무섭게 추격을 따라 붙으며 1위를 제외한 파운드리 시장 순위 변동이 치열해질 것이라는 관측이 따른다. 8일 증권가 및 외신 등에 따르면 TSMC 첨단 패키징 공정인 ‘칩 온 웨이퍼 온 서브스트레이트(CoWoS)’ 캐파(생산량)는 웨이퍼(반도체 원판) 기준 올해 말 월 4만 장, 내년 말 7만8000장 수준으로 상향 조정되고 있다. 이는 올해와 내년 각각 기존 전망치인 3만5000장, 7만 장 대비 높아진 수치다. TSMC의 CoWos 패키징 라인을 이용하는 주요 고객 엔비디아를 비롯해 AMD, 브로드컴 등 AI 가속기용 GPU를 만드는 회사들의 수요가 늘어난 데 따른 것으로 풀이된다. 특히 내년 하반기부터는 엔비디아의 최신 GPU 아키텍처 블랙웰의 'B300' 시리즈가 출시를 앞두고 있어 TSMC는 고객 맞춤형으로 고도화된 공정 도입에 속도를 낼 방침이다. 실제 B300 공정 생산에는 더 복잡한 패키징 공정인 CoWoS-L이 필요하다. CoWoS-L은 재배선층(RDL)을 기반으로 로컬 실리콘 인터포저(반도체 칩과 기판 사이를 중재하는 부품)를 연결 단자로 사용하는 방식을 채택하는 등 보다 정교한 패키징 공정을 요구한다. 기술적 난이도가 높아 차세대 패키징 방식으로 불린다. 내년부터는 블랙웰 수요에 맞춰, TSMC의 CoWoS 캐파 중 CoWoS-L이 차지하는 비중이 기존에 주로 사용하던 CoWoS-S가 차지하는 비중보다 더욱 커질 것으로 관측되고 있다. 이처럼 주요 고객사가 TSMC로 몰리고 있는 가운데, 파운드리 경쟁사인 삼성전자도 아이큐브(I-Cube)라는 이름의 첨단 패키징 기술을 개발했지만, 애초에 고객사 확보 자체에 난항을 겪으며 주춤하는 것으로 알려졌다. 업계 관계자는 "삼성전자는 3㎚(나노미터, 10억분의 1m) 공정을 기반으로 (주요 글로벌 빅테크) 고객들로부터 수주를 받으려고 하지만 수율(양품 비율) 등이 안 좋아 당초 계획대로 움직이지를 못하는 상황"이라고 짚었다. 삼성전자의 글로벌 시장 점유율(매출 기준)은 다른 파운드리사들과도 반대로 가고 있다. 시장조사업체 트렌드포스에 따르면 올 3·4분기 세계 상위 10대 파운드리의 총 매출은 전분기 대비 9.1% 증가한 349억 달러다. 이중 TSMC의 3·4분기 매출은 235억2700만 달러로 전분기 대비 13.0% 증가하며 1위 자리를 굳혔다. 하지만 삼성전자의 경우 2위 자리는 유지했지만, 매출은 전분기 대비 12.4% 감소했다. 시장점유율도 2분기 11.5%에서 3분기 9.3%로 떨어졌다. 그에 반해 중국 파운드리사들은 두 자릿수 매출 성장세를 보이며, 추격의 불을 당기고 있다. 중국 SMIC는 올해 3·4분기 제품 믹스 최적화와 12인치 용량의 추가 출시로 출하량이 증가하면서 6.0%의 점유율을 차지하며 3위를 기록했다. 매출은 21억7100만달러로 20억달러를 넘어섰다. soup@fnnews.com 임수빈 기자
2024-12-06 16:51:36 -
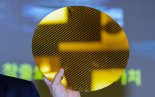 정부, 7년간 '반도체 첨단패키징'에 2744억 투입
정부, 7년간 '반도체 첨단패키징'에 2744억 투입
[파이낸셜뉴스] '반도체 강국' 한국에서 상대적으로 취약하다는 평가를 받는 첨단 패키징 기술 경쟁력을 강화하기 위해 정부가 7년간 2700억 원 넘는 예산을 투입한다. 산업통상자원부는 11일 서울 서초구 엘타워에서 반도체 관련 기업·기관 10곳이 이 같은 내용의 '반도체 첨단 패키징 산업 생태계 강화를 위한 업무협약(MOU)'을 체결했다고 밝혔다. 이날 MOU에는 삼성전자, SK하이닉스, LG화학, 하나마이크론, 한미반도체, 세미파이브 등 종합반도체·팹리스(반도체 설계 전문회사)·소부장(소재·부품·장비) 기업과 한국PCB&반도체패키징산업협회, 차세대지능형반도체사업단, 한국반도체산업협회, 한국산업기술기획평가원 등 협회·기관이 참여했다. 반도체 패키징은 원형 웨이퍼 형태로 생산된 반도체를 자르고 전기 배선 등을 연결해 기기에 탑재할 수 있는 형태로 조립하는 작업으로, 후공정(後공정·OSAT)이라 불린다. 기존에는 웨이퍼·칩을 외부 충격이나 과도한 온도·습도로부터 보호해주는 역할만 했으나, 최근에는 미세 공정의 기술적 한계를 극복하기 위해 여러 반도체를 묶어 성능을 최적화하는 첨단 기술로 부각되며 중요성이 날로 커지고 있다. 범용 D램 여러 장을 수직으로 쌓아 올린 뒤 연결해 하나로 기능하게 해 성능을 극대화한 고대역폭 메모리(HBM)는 날로 커지는 패키징 기술의 중요성을 보여주는 대표 사례다. 산업부는 패키징 산업 경쟁력 강화를 위해 추진해온 '반도체 첨단 패키징 선도 기술개발 사업'이 지난 6월 정부의 예비타당성조사(예타)를 통과해 안정적인 예산 확보가 가능해지자 성공적인 사업 추진을 위해 이날 MOU를 추진했다. 이 사업에는 2025∼2031년 총 2744억 원이 투입된다. 산업부는 이 사업을 통해 첨단 패키징 초격차 선도 기술 개발, 소부장 및 OSAT 기업의 핵심 기술 확보, 차세대 기술 선점을 위한 해외 반도체 전문 연구기관과의 협력 체계 구축 등을 추진할 계획이다. 이와 함께 첨단 패키징 기술 개발에 필요한 인력양성 등 후공정 산업 육성을 위한 지원을 지속적으로 추진할 예정이다. 이승렬 산업부 산업정책실장은 "글로벌 반도체 첨단 패키징 기술 경쟁력 확보를 위해 우리 기업들의 적극적인 기술개발 협력을 요청한다"며 "정부도 업계 노력에 발맞춰 필요한 모든 지원을 아끼지 않겠다"고 말했다. leeyb@fnnews.com 이유범 기자
2024-09-11 14:46:20 -
 SK하이닉스 "HBM 석권 비결은 첨단 패키징"
SK하이닉스 "HBM 석권 비결은 첨단 패키징"
[파이낸셜뉴스] SK하이닉스가 고대역폭메모리(HBM) 시장을 석권한 배경에는 '어드밴스드 매스 리플로우 몰디드 언더필(MR-MUF)'이라는 첨단 패키징 기술이 핵심 역할을 한 것으로 파악됐다. 이규제 SK하이닉스 PKG제품개발 담당 부사장( 사진)은 5일 "표준 규격에 따라 제품 두께는 유지하면서도 성능과 용량을 높이기 위한 칩 고단 적층의 방편으로 최근 하이브리드 본딩 등 차세대 패키징 기술이 주목받고 있다"고 밝혔다. 이 부사장은 이날 SK하이닉스 뉴스룸과 인터뷰에서 하이브리드 본딩 기술과 관련 "위 아래 칩간 간격이 좁아져 생기는 발열 문제는 여전히 해결해야 할 과제이지만, 점점 더 다양해지는 고객의 성능 요구를 충족시킬 솔루션으로 기대를 모으고 있다"며 이 같이 언급했다. 하이브리드 본딩은 칩을 적층할 때, 칩과 칩 사이에 범프를 형성하지 않고 직접 접합시키는 기술이다. 이를 통해 칩 전체 두께가 얇아져 고단 적층이 가능해진다. 16단 이상의 고대역폭메모리(HBM) 제품에서 필요성이 대두되는 가운데 SK하이닉스는 어드밴스드 MR-MUF과 하이브리드 본딩 방식을 모두 검토하고 있다. 이 부사장은 HBM 시장 선두가 된 일등공신으로 MR-MUF 기술을 한 번 더 고도화한 ‘어드밴스드 MR-MUF'를 꼽았다. 이 부사장은 "12단 HBM3부터는 기존보다 칩의 적층을 늘렸기 때문에 방열 성능을 더욱 강화해야 했다"며 "특히 기존 MR-MUF 방식으로는 12단 HBM3의 더 얇아진 칩들이 휘어지는 현상 등을 다루기 쉽지 않았다"고 전했다. 이어 "이러한 한계를 극복하기 위해 회사는 기존의 MR-MUF 기술을 개선한 어드밴스드 MR-MUF 기술을 개발했다"고 했다. 그는 "이를 통해 지난해 세계 최초로 12단 HBM3 개발 및 양산에 성공했으며, 이어 올해 3월 세계 최고 성능의 HBM3E를 양산하게 됐다"며 "이 기술은 하반기부터 AI 빅테크 기업들에 공급될 12단 HBM3E에도 적용되고 있으며, SK하이닉스의 HBM 1등 기술력을 더 공고히 하는 데 힘이 될 것"이라고 했다. mkchang@fnnews.com 장민권 기자
2024-08-05 14:30:58 -
 美 "반도체 첨단 패키징 기업 16억弗 지원"
美 "반도체 첨단 패키징 기업 16억弗 지원"
【 샌프란시스코=홍창기 특파원】 9일(현지시간) 미국 샌프란시스코 모스콘 센터는 미국 반도체에 대한 관심으로 뜨거웠다. 미국과 유럽, 일본 등 40여개국, 600여개 반도체 소재·장비회사들이 이날 개막된 미국 최대 반도체 장비·재료 전시회 '세미콘 웨스트(SEMICON WEST) 2024'에 전시관을 꾸렸다. 코로나19 팬더믹 이후 완전한 오프라인 행사로 진행된 지난해보다 참석자와 참가 기업이 크게 늘어났다는 것이 행사를 주최한 국제반도체장비재료협회(SEMI)의 설명이다. 주최측은 11일까지 진행되는 행사에 3만명 정도가 참가할 것으로 내다봤다. 미국 상무부 로리 로카시오 차관은 이날 기조연설에 나서 "미국의 반도체 첨단 패키징 역량을 구축하고 이를 가속화할 새로운 연구개발(R&D) 공모를 시작한다"고 깜짝 발표했다. 이어 "국가 첨단 패키징 제조 프로그램(NAPMP) 비전에 명시된 것처럼 5개 R&D 분야에 최대 16억달러의 자금을 투입할 것"이라고 밝혔다. 미국 정부가 반도체법으로 확보한 총 2800억달러(약 380조 원)의 보조금 일부를 첨단 패키징 분야에 쓰겠다고 밝힌 것은 이번이 처음이다. 상무부는 개별 계약마다 약 1억5000만달러(2078억원)를 지원할 예정이다. 이와 관련 지나 러몬도 상무부 장관은 "첨단 패키징에 대한 지원으로 미국은 다양한 첨단 패키징 옵션을 확보하고 새로운 첨단 패키징 기술을 확보하게 될 것"이라고 말했다. 세미콘 웨스트 2024에는 한국 기업들도 많이 보였다. 산업통상자원부와 코트라가 마련한 한국관에는 12개 한국기업이 부스를 마련했고 전체적으로는 60여개 한국 기업이 세미콘 웨스트에 참석했다. 이는 377개가 참여한 미국에 이어 두 번째로 많은 규모다. 삼성전자에 반도체 소재를 공급하고 있는 레이크머티리얼즈 김진동 대표는 "삼성전자의 테일러 진출을 계기로 다른 사업 부문의 확장도 기대하고 있다"고 말했다. 해성의 이영배 미국 지사장은 "AI 산업과 관련된 하이엔드 반도체 시장은 물론, 우리가 주력하고 있는 전장용 반도체 수요도 꾸준하다"라면서 "이번 행사에서 열릴 여러 미팅 등에서 다양한 시도를 해볼 생각"이라고 말했다. 코트라 실리콘밸리 무역관 김형일 관장은 "우리 기업들이 실리콘밸리 현지에서 사업을 확장할 수 있도록 다각도로 지원할 것"이라고 강조했다. 주샌프란시스코대한민국총영사관 임정택 총영사는 "반도체 산업 전 분야에 걸쳐 우리 기업들의 기술력과 역량을 느낄수 있었다"면서 "한국 반도체 기업들의 성공을 위해 총영사관도 적극 지원할 계획"이라고 말했다. theveryfirst@fnnews.com
2024-07-10 18:23:43 -
 CJ대한통운, 첨단 패키징 기술로 '물류 혁신' 나선다
CJ대한통운, 첨단 패키징 기술로 '물류 혁신' 나선다
[파이낸셜뉴스] CJ대한통운이 첨단 패키징 기술을 통해 물류업계의 새 표준을 제시하고 있다. 11일 CJ대한통운에 따르면 패키징혁신센터에서 개발된 의류 특화 폴리백 패키징 설비 '앱스(APPS)어패럴 자동 포장 시스템'과 '원터치 박스&송장'을 최근 고객사 물류에 적용했다. 앱스는 원단 위로 의류를 일렬로 배열해 이동시키면서 감싼 뒤 포장까지 자동 마무리하는 설비다. 앱스를 이용하면 자동화에 따른 물류비 절감뿐 아니라 재활용 플라스틱(PCR) 포장재, 가위가 필요 없는 '이지컷' 적용 등으로 분리배출의 불편함도 줄일 수 있다. 원터치 박스&송장은 테이프를 쓰지 않으면서도 상자 포장을 할 수 있는 기술이다. 패키징혁신센터는 화성 동탄 물류단지에 조성된 연구조직이다. 내부에는 △운송 중 발생할 수 있는 압축·적재·진동 시험을 위한 패키징 안전성 연구실 △운송 과정의 온·습도 환경을 재현한 물류환경 시험 연구실 △자동화설비 검증실 △샘플 제작실 등이 들어서 있다. 패키징혁신센터는 택배상자 파손 가능성을 획기적으로 줄이는 연구개발(R&D)에도 매진 중이다. 수백번의 낙하실험과 함께 가혹한 상자 적층 및 진동 환경, 온도 변화 등의 테스트를 거쳐 가장 안전하면서도 경제적인 물류 시스템을 구축하겠다는 포부다. 센터는 또한 여러 각도와 축에 따라 택배 상자에 약 6만회의 진동과 충격을 주는 '진동 환경 시험', 영하 25도에서 영상 40도에서 택배 내용물의 변화를 측정하는 패키징 온도 테스트도 진행 중이다. 각각 일반 도로뿐 아니라 비포장도로나 연석 등 다양한 진동 상황에서의 내구성 담보, 운송 시 온도 변화가 일어나지 않는 패키징을 개발하려는 취지다. CJ대한통운은 테스트로 입증된 데이터를 기반으로 '상품고정형 패키징'을 연내 상용화 해 고객사와 소비자 편의를 끌어 올린다는 계획이다. 이를 통해 고객사는 상품별 안정화·효율화된 박스 공급을 통한 파손 위험 및 비용 절감 효과를, 소비자에게는 빠르고 안전하면서도 최적화된 박스 포장으로 구매 만족도를 제고할 수 있을 것으로 기대된다는 게 회사 측의 설명이다. 김찬우 CJ대한통운 패키징 기술팀장은 "패키징을 비롯해 물류 프로세스 혁신을 위해서는 시장과 고객에 대한 이해, 페인 포인트에 대한 해결 의지가 중요하다"며 "다양한 고객 접점을 통해 얻은 데이터를 토대로 제품 특성과 배송 요구사항에 최적화된 패키징 컨설팅을 제공하겠다"고 말했다. welcome@fnnews.com 장유하 기자
2024-04-11 09:14:02 -
 반도체 첨단패키징 R&D에 394억원 지원
반도체 첨단패키징 R&D에 394억원 지원
[파이낸셜뉴스] 반도체 첨단패키징 초격차 기술개발을 위해 해외 선도연구기관 및 선도기업과의 기술협력 지원 사업이 올해부터 본격적으로 추진된다. 산업통상자원부는 국내 반도체 첨단패키징 관련 기술경쟁력 확보를 위해 '전자부품산업 기술개발(첨단전략산업 초격차 기술개발 반도체)' 사업을 오는 14일 공고한다고 13일 밝혔다. 첨단패키징은 디지털 전환에 따른 고성능·다기능 반도체 수요 증가로 미세 공정의 기술적 한계 극복 및 개별 소자들의 단일 패키지화 필요성 증가에 따라 핵심기술로 부상했다. 특히 칩렛, 3D 등의 첨단패키징 기술 구현을 위한 이종접합 및 다단 적층용 신규소재 개발과 선단 공정개발은 반도체 초격차 기술확보의 화두가 됐다. 이에 산업부는 첨단패키징 기술경쟁력 확보를 위해 글로벌 선도연구기관 및 선도기업과의 연구개발(R&D) 협력체계 구축 및 공동연구 개발을 위한 신규사업을 공고했다. 이번 사업은 총사업비 394억원(올해 198억원) 규모로 국비·민간 부담금 매칭 방식으로 지원된다. 지원분야는 첨단패키징 공정·장비, 분석·검사, 소재로 지원 대상은 국내 반도체 관련 학계, 연구계, 기업이며 선정된 기관은 33개월간 정부출연금 총 55억5000만원 이내의 지원을 받을 수 있다. 이번 사업은 14일부터 다음달 14일까지 접수할 예정으로, 사업공고의 상세내용은 범부처통합연구지원시스템에서 확인가능하다. 산업부 관계자는 "첨단패키징은 시스템반도체 글로벌 공급망 확보를 위한 핵심 분야로 정부는 '반도체 첨단패키징 선도기술 개발'을 위한 대규모 R&D사업 추진 등을 포함하여 반도체 패키징 기술경쟁력 강화 및 견고한 생태계 조성을 위해 지속적으로 노력하겠다"고 밝혔다. leeyb@fnnews.com 이유범 기자
2024-02-13 13:27:27 -
 반도체 첨단 패키징 선도기술 확보 위한 민관 공동협력 체계 구축
반도체 첨단 패키징 선도기술 확보 위한 민관 공동협력 체계 구축
[파이낸셜뉴스]반도체 첨단 패키징 선도기술 확보를 위한 민관 공동협력 체계가 구축된다. 산업통상자원부는 민관 협력 반도체 첨단 패키징 기술개발을 위해 29일 서울 엘타워에서 업무 협약식을 개최했다. 이날 행사에는 삼성전자, SK하이닉스, 소부장(소재·부품·장비), 반도체 후공정 전문업체(OSAT) 및 반도체 설계기업(팹리스) 등이 참여해 '반도체 첨단 패키징 기술개발 협력에 관한 협약'을 체결했다. 이재용 삼성전자 회장이 지난 2월 삼성전자 천안캠퍼스를 찾아 패키지 라인을 둘러보고 사업전략을 점검했다. 이들은 반도체 첨단 패키징 선도기술 확보를 위한 적극적인 상호 협력과 첨단 패키징 선순환 생태계 구축을 통한 반도체 후공정 산업 육성 등을 위해 적극적으로 협조해 나가기로 했다. 첨단 패키징은 디지털 전환에 따른 저전력·고성능을 구현하기 위한 다기능·고집적 반도체의 수요증가로, 반도체 공정 미세화 기술의 한계 극복 및 개별 소자들의 단일 패키지화 필요성 증가에 따라 핵심 기술로 부상했다. 산업부는 변화하는 패키징 시장의 적기 진입을 위해 첨단 패키징 관련 신규 연구개발(R&D)을 추진하고 있다. 글로벌 반도체 첨단 패키징 산업의 기술 주도권 확보를 통한 시스템반도체 산업의 레벨업을 위해 산학연 전문가들과 함께 '반도체 첨단 패키징 선도기술 개발'을 위한 대규모 R&D 사업도 준비하고 있다. 아울러 반도체 위탁생산(파운드리) 및 종합반도체업체(IDM) 등 기업의 수요를 적극적으로 반영해 고집적·고기능·저전력 첨단 패키징 초격차 기술개발, 국내 소부장 및 OSAT 기업의 핵심 기술 확보, 차세대 기술 선점를 위한 미·유럽연합(EU) 등 반도체 전문 연구기관 및 글로벌 OSAT 기업과 협업 체계구축 등의 사업을 추진할 예정이다. 주영준 산업부 산업정책실장은 "글로벌 반도체 첨단 패키징 선도기술 확보를 위해 기업들의 적극적인 기술개발 협력 및 과감한 투자를 요청한다"며 "정부도 업계의 노력에 발맞춰 반도체 패키징 기술 경쟁력 강화 및 견고한 생태계 조성을 위해 지원과 협력을 아끼지 않겠다"고 강조했다. leeyb@fnnews.com 이유범 기자
2023-08-29 13:17:28 -
 충남도, '충남형 반도체 첨단패키징' 대전환
충남도, '충남형 반도체 첨단패키징' 대전환
[파이낸셜뉴스 홍성=김원준 기자] 충남도가 반도체 후공정에 특화된 지역 특성을 살릴 수 있는 ‘충남형 반도체 첨단패키징’ 전환에 나선다. 충남도는 19일 도청 소회의실에서 유재룡 산업경제실장과 충남도의회 안장헌·이지윤 의원, 관련 전문가 등 15명이 참석한 가운데 ‘충남 반도체 발전방안 수립 최종보고회’를 개최했다. 참석자들은 지난해 8월 정부의 국가첨단전략산업법 시행과 11월 국가첨단전략기술 지정에 따른 대응방안을 모색하고, 반도체 패키징 패권 경쟁에서 우위를 점하기 위한 방안을 논의했다. 지난해 기준 세계 반도체 시장에서 시스템반도체와 메모리반도체 시장규모는 각각 3456억 달러(약 425조 원), 1344억 달러(약 165조원)로 시스템반도체 시장이 월등히 크다. 우리나라는 반도체 강국으로 불리고 있지만 실상은 반도체 매출의 약 90%를 메모리반도체가 차지하고 있으며, 시스템반도체 세계 시장점유율은 3% 수준에 불과하다. 이날 연구 책임을 맡은 정희운 호서대 교수는 세계적 반도체 패권 경쟁에서의 위기 등을 분석하고, 충남을 ‘세계 최고의 반도체 후공정 산업메카’로 육성해야 한다고 강조했다. 세부 추진전략으로는 △후공정 역량 강화 △소부장기업 간 연계 협력 △반도체 산업 경쟁력 지원 △전문인력 양성 △디스플레이 등 수요산업과의 연계 등을 정책 방향으로 한 ‘첨단 패키징 클러스터 조성’을 제안했다. 이는 충남의 반도체 산업이 아산에 입지한 삼성전자 온양사업장을 중심으로, 전공정에서 생산된 반도체 칩을 가공해 완성품으로 만드는 후공정 전문 중견·중소기업(패키징·테스트)이 견인하고 있기 때문이다. 충남도는 지역산업진흥계획에서 지역 미래신산업에 반도체 첨단패키징 분야를 추가했으며, 기업·전문혁신기관 등과 함께 핵심 사업 및 미래 신성장동력을 발굴하고, 주력산업을 고도화하기 위해 지속적으로 논의할 계획이다. 안장헌 충남도의원은 “지금은 세계적 경기침제가 계속되고 있는 상황으로, 후공정 산업의 육성 필요성에 공감한다”며, “도의회 차원에서도 새로운 미래 산업을 위해 적극 협조하겠다”고 말했다. 유재룡 충남도 산업경제실장은 “이번 회의는 도내 주력산업의 한 축으로 반도체산업의 발전방안을 심층적으로 논의하기 위한 자리로 마련했다”며 “앞으로 명실공히 충남이 세계 최고의 반도체 후공정 메카로 자리매김 하도록 노력하겠다”고 말했다. kwj5797@fnnews.com 김원준 기자
2023-04-19 12:55:10 -
 인하대, 첨단 반도체 패키징 센터 설립
인하대, 첨단 반도체 패키징 센터 설립
【파이낸셜뉴스 인천=한갑수 기자】 인하대학교는 인천시의 지역특화 전략산업인 반도체산업 집중육성 정책에 발맞춰 ‘인하 첨단 반도체 패키징 센터’를 설립한다고 2일 밝혔다. ‘인하 첨단 반도체 패키징 센터’는 반도체 패키징 분야 기술개발과 산학 연구역량 결집을 통한 반도체 산업 생태계 조성 일환으로 설립됐다. 센터는 차세대 후공정산업 촉진을 위해 수요 기반의 반도체 패키징 전문인력 양성 및 재직자 기술교육, 반도체 후공정 및 소부장 기술·제품 개발, 반도체 공동활용 기반시설 및 공동장비 인프라 구축, 반도체 패키징 시험 및 분석서비스 운영 등 산학 공동 연구·개발과 사업화를 추진한다. 센터에는 기계, 재료, 전기, 전자, 정보통신공학과 등 8개 학과 17명의 교수가 연구진으로 참여하고 패키징 관련 소재, 공정설계, 공정장비, 테스트·신뢰성, 교육 등 5개 전문 분과로 운영된다. 센터장은 인하대 산학협력부단장이자 인천반도체포럼 등 산학연관 협의체를 주도하고 있는 김주형 기계공학과 교수가 맡는다. 특히 인하대는 앞으로 지역 대표 산업인 자동차, 항공, 도심항공 모빌리티(UAM), 개인용 비행체(PAV) 등을 포함하는 미래 모빌리티 기술과 신재생에너지 및 청정에너지 분야와 연관된 기술개발까지 확장한다는 계획이다. 현재 인천에는 반도체 후공정분야 세계 2·3위 앵커기업 등 1264개 사의 관련 기업이 포진해 있으며 시스템반도체가 수출 증가의 주도적 역할을 하고 있다. 인하대는 인천시의 주요 반도체 사업 관련 연구를 수행하며 산학연관의 인천형 반도체 산업을 주도하겠다는 방침이다. 또 인하대는 반도체 패키징 기술과 관련된 유기적인 융합연구를 위해 반도체 패키징 및 첨단 반도체를 연구하는 유럽의 아이멕(IMEC), 독일의 프라운호퍼(Fraunhofer), 미국 조지아공과대학(Georgia Institute of Technology) 등과 협력을 추진 중이다. 조명우 인하대 총장은 “패키징 연구센터를 대한민국을 넘어 글로벌 무대에서 선도적 역할을 할 수 있는 핵심 기관으로 육성할 것”이라고 말했다. kapsoo@fnnews.com 한갑수 기자
2022-11-02 16:11:41


